Con lo sviluppo rapido dei circuiti integrati (IC) su scala molto grande, le esigenze di assemblaggio elettronico non possono più essere soddisfatte dai tipi di package tradizionali e nuovi package nascono grazie alla spinta delle richieste in termini di maggiore integrazione, dimensioni ridotte della scheda e numero più elevato di I/O. Tra tutti i nuovi tipi di package sopra menzionati, il package BGA (ball grid array) è un tipo primario con i campi di applicazione più ampi grazie alla sua diversità, che supera molteplici limitazioni tipiche dei package tradizionali. Dal punto di vista degli elementi relativi alle tecnologie di saldatura, il package BGA è difficilmente diverso dai package tradizionali, ad esempio il QFP (quad flat package). Tuttavia, i pin sono sostituiti da sfere di saldatura, che possono essere considerate una rivoluzione nell’assemblaggio elettronico e che ha portato all’avvento di package derivati come il CSP (chip scale package). Al momento, la saldatura BGA deve ancora essere eseguita applicando la tradizionale SMT (surface mount technology) e la saldatura BGA può ancora essere effettuata nella comune SMTattrezzatura di assemblaggioQuesto articolo discuterà alcuni fattori che influenzano l’applicazione delle tecnologie di assemblaggio BGA, tra cui la progettazione dei pad BGA, la stampa della pasta saldante, la precisione dell’allineamento di montaggio, le curve di temperatura di saldatura e i difetti di saldatura.
Fattibilità della progettazione dei pad BGA
I package BGA rientrano in un paio di classificazioni basate su diversi passi. In generale, la progettazione dei pad BGA dovrebbe tenere inizialmente in considerazione la fattibilità del tracciamento CAD e la producibilità del PCB (printed circuit board). I pad BGA esistono anche in numerosi tipi e possono essere liberamente selezionati quando lo spazio lo consente, con i seguenti tipi comunemente utilizzati.
• Pad a osso di cane
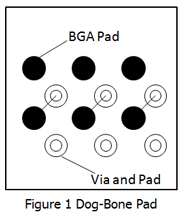
Il pad a forma di osso di cane sfrutta i via per condurre le tracce verso altri strati, per cui sono stati imposti alcuni limiti alle dimensioni del pad. A causa della presenza dei via, durante il processo di produzione del PCB tendono a generarsi alcuni difetti, come il ponte di saldatura dovuto al distacco della solder mask. Pertanto, le dimensioni del pad devono essere progettate rispettando rigorosamente il livello produttivo effettivo, in modo da ridurre al minimo i difetti di saldatura generati durante la saldatura BGA e lasciare spazio per un eventuale rework BGA in futuro.
• Vias distribuite esternamente ai pad BGA
Questo tipo di piazzola funziona meglio per componenti BGA con un basso numero di I/O. Questo tipo di progettazione della piazzola offre praticità per la saldatura e lascia più spazio libero per le dimensioni della piazzola. Naturalmente, devono essere soddisfatti i requisiti fondamentali in termini di tracciatura. Pertanto, è quasi impossibile sfruttare questo tipo di piazzola su BGA con un numero più elevato di I/O.
• Pad via-in-pad
Via in padsi sviluppa insieme ai progressi della tecnologia microvia nella fabbricazione di PCB.
A parte dal tipo di pad, la solder mask e la posizione dei pad BGA sono direttamente associate alla saldatura BGA. In base alle diverse posizioni della solder mask, i pad BGA si dividono in due tipi: pad SMD (solder mask defined) e pad NSMD (non solder mask defined), con rispettive funzioni nella saldatura BGA. Quando si applica un pad SMD, il pad presenta un’ampia area di adesione con il pad stesso, il che porta a un’area di adesione altrettanto ampia tra i giunti di saldatura e il circuito stampato (PCB). Tuttavia, con l’aumentare delle dimensioni del pad, lo spazio tra i pad adiacenti si riduce, influenzando la distribuzione dei via pad e la capacità di instradamento.
Durante la procedura di fabbricazione del PCB, se la solder mask devia nella stessa direzione, il pad BGA non ne risente, il che è vantaggioso per la saldatura BGA. Tuttavia, questo tipo di pad tende a rompersi durante il rework della solder mask sul bordo, il che è sfavorevole per l’effetto del rework. Una volta utilizzato il pad NSMD, il pad risulterà relativamente piccolo, il che è vantaggioso per la distribuzione dei via pad e per il tracciamento. Tuttavia, questo tipo di struttura del pad comporta una diminuzione dell’area di adesione tra i giunti di saldatura e il pad, riducendo ulteriormente l’intensità di adesione del giunto di saldatura. In sintesi, entrambi i tipi di pad presentano vantaggi e svantaggi propri e il pad corrispondente può essere determinato in base alle considerazioni tecnologiche.
Stampa della pasta saldante
La stampa della pasta saldante svolge un ruolo chiave nel determinare la qualità della saldatura. La stampa della pasta saldante consiste nella trasformazione accurata della pasta saldante dallo stencil al pad, con il coinvolgimento di stencil, pasta saldante e stampante. La precisione della stampante per pasta saldante deve innanzitutto soddisfare i requisiti dell’assemblaggio BGA. Lo stencil determina la quantità di pasta saldante attraverso il suo spessore e la dimensione delle aperture. La quantità di pasta saldante richiesta dal package BGA è solitamente determinata da 3 aspetti:
• È necessario utilizzare una quantità sufficiente di stagno per garantire eccellenti connessioni di saldatura BGA.
• La quantità di pasta saldante dovrebbe compensare l’errore di coplanarità delle sfere di saldatura (solitamente 0,1 mm) dei componenti BGA.
• Quando sulla scheda a circuiti stampati sono presenti altri componenti a passo fine, la quantità di pasta saldante dovrebbe essere valutata in modo globale per evitare che si verifichino ulteriori difetti di saldatura.
Precisione di posizionamento
Le posizioni accurate dei componenti BGA sul circuito stampato dipendono totalmente dalla precisione delle macchine di montaggio dei chip, la maggior parte delle quali include uno specifico sistema di posizionamento in grado di contribuire a ottenere un posizionamento accurato dei componenti BGA. Inoltre, alcune macchine di montaggio dei chip possono persino ispezionare le sfere di saldatura BGA in termini di co-planarità e riconoscere alcuni difetti come le sfere mancanti, il che è estremamente utile per il miglioramento dell’affidabilità della saldatura BGA.
Inoltre, si possono adottare altre misure per migliorare ulteriormente la precisione di montaggio dei componenti BGA. Ad esempio, si possono impostare riferimenti locali sulla parte esterna dei pad BGA oppure predisporre un paio di linee di piega come riferimenti per l’ispezione manuale dopo l’assemblaggio, entrambe soluzioni che si sono dimostrate efficaci nella produzione pratica.
Inoltre, i componenti BGA presentano un evidente effetto di autoallineamento durante il processo di saldatura a causa della tensione superficiale della saldatura, quindi alcuni progettisti ingrandiscono volutamente i pad sui quattro angoli nella progettazione dei pad BGA, rendendo l’effetto di autoallineamento più evidente per garantire che i componenti BGA possano autoriposizionarsi quando le posizioni di montaggio risultano spostate.
Curva di temperatura di saldatura e difetti di saldatura
La curva di temperatura di saldatura determina direttamente la qualità della saldatura. Una curva di temperatura di solito include quattro fasi: fase di preriscaldo, fase di ammollo, fase di rifusione e fase di raffreddamento, ognuna delle quali è caratterizzata da diversi cambiamenti fisici/chimici. Poiché l’impostazione della curva di temperatura determina il processo di formazione dei giunti di saldatura, essa è strettamente correlata all’affidabilità dei giunti di saldatura. A causa della particolarità del package BGA, è estremamente difficile generare una curva di temperatura soddisfacente. In generale, un componente BGA richiede la misurazione di tre temperature: la temperatura dell’involucro, la temperatura della superficie del circuito stampato e la temperatura del giunto di saldatura interno del BGA.
Tecnologie di ispezione e rilavorazione BGA
Poiché tutte le giunzioni di saldatura BGA si trovano sotto i package dopo la saldatura, i metodi di ispezione tradizionali, come il test a sonda mobile o l’ispezione visiva, non riescono a soddisfare le esigenze pratiche. Fino ad ora, i metodi principali che possono eseguire la scansione dei difetti di saldatura delle giunzioni BGA sonotest AOI (ispezione ottica automatizzata)etest AXI (ispezione automatizzata a raggi X).
In base alle proprietà della struttura BGA, è quasi impossibile ispezionare un singolo giunto di saldatura di un componente BGA. Tuttavia, l’intero corpo del package deve essere rilavorato.
Altri fattori
Nel processo di assemblaggio BGA devono essere considerati altri fattori, come la protezione elettrostatica e la prebollitura (baking) dei componenti BGA. Di solito, i componenti BGA richiedono imballaggi speciali con requisiti di protezione elettrostatica. Durante il processo di assemblaggio dei circuiti stampati, devono essere adottate rigorose misure di protezione elettrostatica, tra cui la messa a terra delle apparecchiature, la gestione del personale e l’amministrazione dell’ambiente.
Assemblaggio BGA a buon prezzo
Con oltre 20 anni di esperienza nella gestioneAssemblaggio PCBle richieste dei clienti di tutto il mondo, abbiamo la capacità di saldare quasi tutti i tipi di componenti sulle schede elettroniche, inclusi i componenti BGA. Se hai domande o dubbi sull’assemblaggio PCB,contattaciper conoscere le nostre capacità di saldatura PCB e discutere progetti personalizzati di popolazione PCB. Sentiti libero di cliccare il pulsante qui sotto per richiedere il prezzo per l’assemblaggio BGA! È COMPLETAMENTE GRATUITO!
Richiesta di preventivo gratuito per l'assemblaggio PCB
Risorse utili
•Un'Introduzione Completa al BGA
•Principali cause delle crepe nella saldatura BGA
•Problemi delle sfere di saldatura dei componenti BGA e come evitarli
•Servizio avanzato di assemblaggio PCB chiavi in mano da PCBCart
•Come ottenere i prezzi per l’assemblaggio PCB
•Come valutare un produttore di PCB o un assemblatore di PCB