Il BGA, acronimo di ball grid array, contiene matrici di sfere di stagno disposte a griglia e le sue sfere di saldatura svolgono il ruolo di interfaccia di connessione tra i circuiti integrati in package (IC) e i PCB. La loro connessione viene realizzata tramite l’applicazione della tecnologia SMT (surface mount technology). La definizione di BGA è stata introdotta da quasi 10 anni e il package BGA sarà accettato in campi di applicazione sempre più ampi grazie alla sua eccellente capacità di dissipazione termica, alle sue proprietà elettriche e alla sua compatibilità con prodotti di sistema ad alta efficienza, resa possibile dall’elevato numero di pin, il che è in realtà inevitabile.
Dopo gli aggiornamenti e le ricerche condotte da numerose aziende, i package BGA si sono evoluti in diverse classificazioni. Questo articolo presenterà una breve introduzione delle loro categorie complessive nella sezione restante, che costituirà un riferimento adatto ai progettisti quando si tratterà di scegliere il BGA ottimale per ottenere il perfetto equilibrio tra prestazioni e costi.
• PBGA
PBGA, acronimo di plastic ball grid array, è stato inventato da Motorola e oggi ha ricevuto la più ampia attenzione e applicazione. Con la resina BT (bismaleimmide triazina) utilizzata come materiale del substrato, insieme all’applicazione delle tecnologie di sigillatura OMPAC (over molded pad array carrier) o GTPAC (glob to pad array carrier), l’affidabilità del PBGA è stata verificata secondo il livello 3 JEDEC. Ad oggi, i package PBGA contenenti da 200 a 500 sfere di saldatura sono ampiamente utilizzati e funzionano al meglio con PCB a doppia faccia.
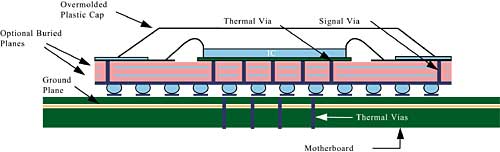
Immagine citata daraffreddamento elettronico
• CBGA
Come indica il suo nome, i package CBGA (ceramic ball grid array) sfruttano la ceramica come materiale del substrato e sfere di stagno (rapporto tra stagno e piombo: 10:90) con un alto punto di fusione. Il chip interno si basa sulla tecnologia C4 (Controlled Collapse Chip Connection) per una connessione perfetta tra BGA e PCB. Questo tipo di connessione è caratterizzato da un’eccellente conducibilità termica e prestazioni elettriche. Inoltre, i CBGA offrono un’affidabilità eccellente, ma con costi elevati. Pertanto, i package CBGA sono più adatti per il settore automobilistico o per chip ad alta efficienza.
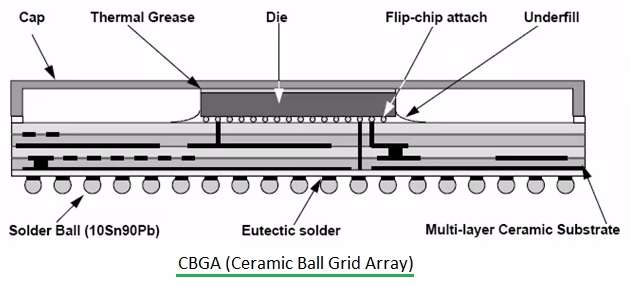
Immagine citata daTest e Misurazione World
• TBGA
TBGA, abbreviazione di tape ball grid array, è in grado di ridurre efficacemente lo spessore del package e di offrire prestazioni elettriche eccellenti. Inoltre, si può ottenere un eccellente effetto di dissipazione termica quando vengono applicati il dissipatore di calore e il design con il chip rivolto verso il basso. Pertanto, il TBGA è adatto a prodotti ad alta efficienza con package sottili. Per i chip rivolti verso il basso, si dovrebbe scegliere la tecnologia flip chip, mentre per i chip rivolti verso l’alto si dovrebbe scegliere il wire bond. In generale, il TBGA presenta un costo più elevato rispetto al PBGA.
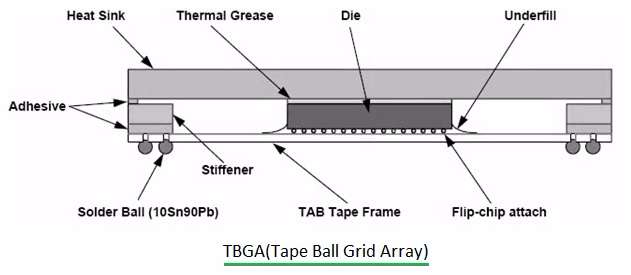
Immagine citata daTest and Measurement World
• EBGA
EBGA (thermal enhanced ball grid array) è un’altra forma di PBGA con l’unica differenza strutturale costituita dall’aggiunta di un dissipatore di calore. Il chip è direttamente fissato al dissipatore con il lato attivo rivolto verso il basso e il collegamento elettrico tra chip e PCB è realizzato tramite wire bond. Il suo metodo di sigillatura procede in questo modo: viene costruita una barriera (dam) sul substrato attorno al chip e poi si utilizza un composto liquido. L’immagine riportata di seguito è un buon esempio di EBGA.

Immagine citata daComponenti pratici
• FC-BGA
FC-BGA è l’abbreviazione di flip chip ball grid array. Simile al CBGA in termini di struttura ma con resina BT utilizzata al posto del substrato ceramico, l’FC-BGA consente un maggiore risparmio sui costi. Inoltre, il flip chip è in grado di accorciare i percorsi dei circuiti interni, migliorando efficacemente le prestazioni elettriche. Il materiale utilizzato per i bump metallici impiegati dal flip chip sfrutta per lo più un rapporto stagno/piombo di 63:37, in modo che questo tipo di materiale presenti una grande tensione superficiale allo stato fuso. Di conseguenza, i chip possono essere tirati nelle posizioni corrette senza l’uso di una macchina di allineamento flip chip ad alta precisione.
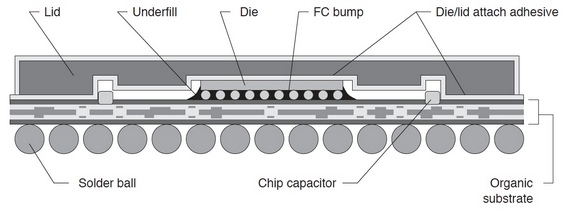
Immagine citata daCircuiti Shipco
• MBGA
MBGA, acronimo di metal ball grid array, è stato sviluppato da Olin con l’impiego di ceramica metallica come substrato. I circuiti sul substrato sono realizzati tramite rivestimento a sputtering con il lato del chip rivolto verso il basso e wire bonding come connessione interna. MBGA può inoltre offrire eccellenti prestazioni elettriche ed un efficace effetto di dissipazione termica.
• Micro BGA
Il micro BGA è un tipo di forma di package con dimensioni equivalenti a quelle dei chip, sviluppato da Tessera. Il micro BGA funziona con il lato del chip rivolto verso il basso e utilizza un nastro di packaging come substrato. Tra il chip e il nastro è inserito uno strato di elastomero per rilasciare le sollecitazioni causate dalla dilatazione termica. Il collegamento tra nastro e chip sfrutta speciali pin d’argento placcati in oro, mentre il collegamento tra la scheda principale e l’ambiente esterno è realizzato tramite BGA. Il vantaggio essenziale del micro BGA risiede nella sua miniaturizzazione e nel suo peso ridotto, che ne determinano l’ampia applicazione in prodotti limitati dallo spazio. Inoltre, è particolarmente adatto per prodotti di memoria con un basso numero di pin.
Hai bisogno di componenti BGA? PCBCart può aiutarti a reperirli tutti a prezzi equi
Ora che sono disponibili così tante classificazioni di BGA, è opportuno scegliere i package BGA ottimali in base alle caratteristiche dei prodotti finali, ai limiti di costo e alle prestazioni e funzioni attese. Il team acquisti di PCBCart fornisce suggerimenti professionali sul tipo ottimale di componenti BGA, tenendo pienamente conto degli elementi sopra menzionati. Inoltre, il 100% dei componenti deve essere controllato prima del loro impiego per garantire che nelle applicazioni finali si ottengano prestazioni perfette.Contattaci per un preventivo gratuito!
Richiedi subito il tuo preventivo per l'assemblaggio BGA
Risorse utili
•Quattro passaggi per conoscere il BGA
•Un'introduzione alla tecnologia di packaging BGA
•Fattori che influenzano la qualità dell’assemblaggio BGA
•Requisiti sui file di progettazione per garantire un assemblaggio BGA efficiente
•Come ottenere un preventivo preciso per le tue esigenze di assemblaggio BGA