BGA(Ball Grid Array)の略称であるボール・グリッド・アレイは、格子状に配置された錫ボールのアレイで構成されており、そのはんだボールがパッケージICとPCB間の接続インターフェースとして機能します。両者の接続は、SMT(表面実装技術)の適用によって実現されます。BGAの定義が発表されてからすでにほぼ10年が経過しており、優れた放熱性能、電気的特性、および多数のピン数による高効率システム製品との高い互換性の結果として、BGAパッケージは今後ますます幅広い応用分野で受け入れられていくことは、実際のところ必然と言えます。
多くの企業による改良と研究を経て、BGAパッケージはさまざまな分類へと発展してきました。本稿の残りのセクションでは、それらの全体的なカテゴリについて簡潔に紹介します。これは、性能とコストの完璧なバランスを実現するために最適なBGAを選定する際、設計者にとって有用な参考資料となるでしょう。
・PBGA
PBGA(plastic ball grid array の略)は Motorola によって発明され、現在では最も広く注目され、応用されているパッケージです。基板材料として BT(ビスマレイミドトリアジン)樹脂を使用し、さらに OMPAC(over molded pad array carrier)または GTPAC(glob to pad array carrier)の封止技術を適用することで、PBGA の信頼性は JEDEC レベル 3 によって検証されています。現在では、200~500 個のはんだボールを含む PBGA パッケージが広く使用されており、両面実装 PCB に最適です。
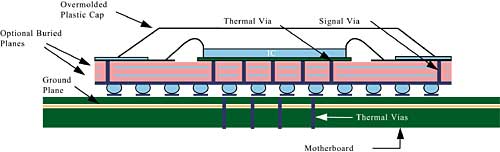
画像引用元エレクトロニクス冷却
・CBGA
その名称が示すとおり、CBGA(セラミック・ボール・グリッド・アレイ)パッケージは、基板材料としてセラミックを用い、高融点のはんだボール(錫と鉛の比率:10:90)を採用しています。内部チップは、BGA と PCB 間の完全な接続を実現するために C4(Controlled Collapse Chip Connection)に依存しています。この種の接続は、優れた熱伝導性と電気的特性を備えています。さらに、CBGA は高い信頼性を有する一方で、コストも高くなります。そのため、CBGA パッケージは自動車用途や高性能チップにより適しています。
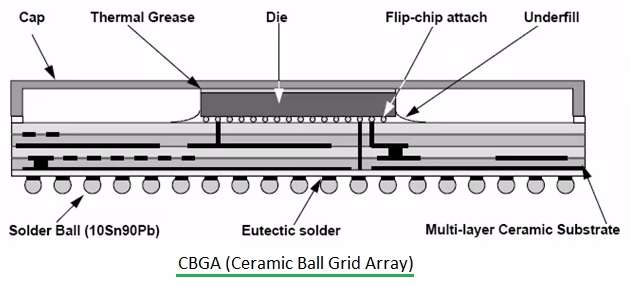
画像引用元テスト&メジャメント・ワールド
・TBGA
TBGA(Tape Ball Grid Arrayの略称)は、パッケージ厚みを効果的に薄型化でき、優れた電気的特性を実現します。さらに、ヒートシンクおよびチップフェイスダウン設計を適用することで、優れた放熱効果が得られます。そのため、TBGAは薄型パッケージの高性能製品に適しています。チップが下向きの場合はフリップチップ技術を選択し、チップが上向きの場合はワイヤボンドを選択する必要があります。一般的に、TBGAはPBGAよりもコストが高いという特徴があります。
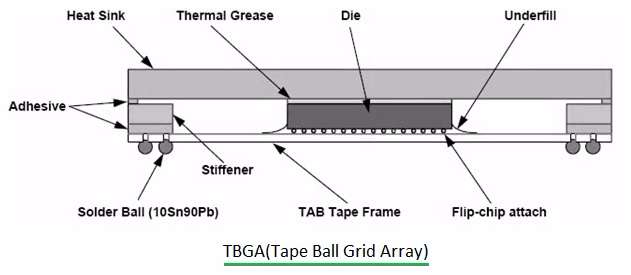
引用画像:テスト&メジャメント・ワールド
・EBGA
EBGA(thermal enhanced ball grid array)は、構造上の違いとしてヒートシンクが追加されている点だけがPBGAの別形態です。チップはフェイスダウンでヒートシンクに直接貼り付けられ、チップとPCB間の電気的接続はワイヤボンドによって実現されます。封止方法は次のようになります。チップの周囲の基板上にダムを形成し、その後に液状コンパウンドを使用します。下に示した画像は、EBGAの良いサンプルです。

画像引用元実践的な構成要素
・FC-BGA
FC-BGA は flip chip ball grid array(フリップチップ・ボールグリッドアレイ)の略です。構造的には CBGA と類似していますが、セラミック基板の代わりに BT レジンを使用することで、FC-BGA はコストをさらに削減できます。さらに、フリップチップは内部回路の経路を短縮できるため、電気的性能を効果的に向上させます。フリップチップで用いられる金属バンプの材料には、錫と鉛の比率が 63:37 のものが主に採用されており、この種の材料は溶融状態で大きな表面張力を発揮します。その結果、高精度なフリップチップ実装機を用いなくても、チップは正しい位置へと引き寄せられます。
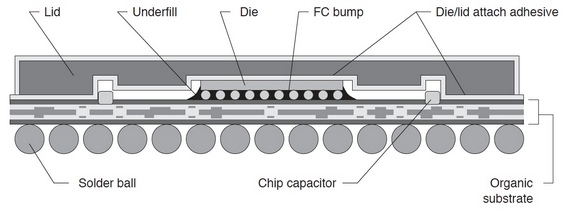
画像引用元Shipco Circuits
・MBGA
MBGA(metal ball grid array の略)は、オーリン社によって開発されたもので、基板としてメタルセラミックが用いられています。基板上の回路は、チップ面を下向きにしてスパッタリングコーティングを行い、内部接続としてワイヤボンディングを用いることで製造されます。MBGA は、優れた電気的特性と放熱性能も提供します。
・マイクロBGA
Micro BGA は、テセラ社によって開発された、チップと同等サイズのパッケージ形態の一種である。Micro BGA は、チップ面を下向きに配置し、パッケージングテープを基板として用いて実装される。チップとテープの間にはエラストマー層が設けられており、熱膨張によって生じる応力を緩和する役割を果たす。テープとチップ間の接続には、金メッキが施された特殊な銀製ピンが用いられ、一方、メインボードと外部環境との接続は BGA を介して実現される。Micro BGA の本質的な利点は、その小型化と軽量性にあり、スペースに制約のある製品で広く利用されている。また、ピン数の少ないストレージ製品にも適したパッケージである。
BGAコンポーネントが必要ですか?PCBCartなら、それらをすべて公正な価格で調達するお手伝いができます
現在では多くの種類のBGA分類が利用可能になっているため、最終製品の特性、コストの制約、そして期待される性能や機能に基づいて、最適なBGAパッケージを選定する必要があります。PCBCartの調達チームは、これらの要素を十分に考慮したうえで、最適な種類のBGA部品に関する専門的な提案を提供します。さらに、最終製品で完璧な性能を発揮できるようにするため、すべての部品は使用前に100%検査されなければなりません。無料お見積もりのご依頼はこちら!
今すぐBGA実装のお見積もりを依頼する
役立つリソース
•BGAを理解するための4つのステップ
•BGAパッケージ技術の概要
•BGA実装の品質に影響を与える要因
•効率的なBGA実装を確保するための設計ファイル要件
•BGA実装のご要望に対して正確な見積もりを取得する方法