BGA ซึ่งย่อมาจาก ball grid array ประกอบด้วยเม็ดบอลดีบุกที่จัดเรียงเป็นตาราง และลูกบอลประสานเหล่านี้ทำหน้าที่เป็นอินเทอร์เฟซการเชื่อมต่อระหว่าง IC แบบแพ็กเกจและแผงวงจรพิมพ์ (PCB) การเชื่อมต่อของมันเกิดขึ้นได้ผ่านการประยุกต์ใช้เทคโนโลยี SMT (surface mount technology) คำจำกัดความของ BGA ได้ถูกเผยแพร่มาเกือบ 10 ปีแล้ว และแพ็กเกจ BGA จะได้รับการยอมรับจากหลากหลายสาขาการประยุกต์ใช้งานมากขึ้นเรื่อย ๆ เนื่องจากความสามารถในการระบายความร้อนที่ยอดเยี่ยม คุณสมบัติทางไฟฟ้าที่ดี และความเข้ากันได้กับผลิตภัณฑ์ระบบประสิทธิภาพสูงอันเป็นผลมาจากจำนวนขาพินที่มีมาก ซึ่งถือเป็นแนวโน้มที่หลีกเลี่ยงไม่ได้
แพ็กเกจ BGA ได้พัฒนาแยกออกเป็นหลายประเภทหลังจากการอัปเกรดและการวิจัยที่ดำเนินการโดยบริษัทจำนวนมาก บทความนี้จะนำเสนอคำแนะนำโดยสรุปเกี่ยวกับหมวดหมู่ภาพรวมของแพ็กเกจเหล่านี้ในส่วนถัดไป ซึ่งจะเป็นข้อมูลอ้างอิงที่เป็นมิตรต่อผู้ออกแบบ เมื่อมีการพิจารณาเลือกใช้ BGA ที่เหมาะสมที่สุดเพื่อให้เกิดความสมดุลที่ลงตัวระหว่างประสิทธิภาพและต้นทุน
• PBGA
PBGA ซึ่งย่อมาจาก plastic ball grid array ถูกคิดค้นโดย Motorola และในปัจจุบันได้รับความสนใจและการใช้งานอย่างแพร่หลายที่สุด โดยใช้เรซิน BT (bismaleimide triazine) เป็นวัสดุของแผ่นรอง (substrate) ร่วมกับการประยุกต์ใช้เทคโนโลยีการหุ้มผนึกแบบ OMPAC (over molded pad array carrier) หรือ GTPAC (glob to pad array carrier) ความน่าเชื่อถือของ PBGA ได้รับการรับรองตามมาตรฐาน JEDEC ระดับ 3 จนถึงปัจจุบัน แพ็กเกจ PBGA ที่มีจำนวนบอลประสานตั้งแต่ 200 ถึง 500 ลูก ถูกนำมาใช้อย่างแพร่หลาย และให้ประสิทธิภาพดีที่สุดเมื่อใช้กับแผ่นวงจรพิมพ์สองหน้า (double-side PCBs)
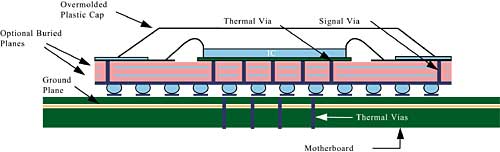
อ้างอิงภาพจากการระบายความร้อนอิเล็กทรอนิกส์
• CBGA
ตามชื่อที่กำหนดไว้ แพ็กเกจ CBGA (ceramic ball grid array) ใช้ประโยชน์จากเซรามิกเป็นวัสดุของซับสเตรตและใช้บอลดีบุก (อัตราส่วนระหว่างดีบุกกับตะกั่ว: 10:90) ที่มีจุดหลอมเหลวสูง ชิปภายในอาศัยเทคโนโลยี C4 (Controlled Collapse Chip Connection) เพื่อให้ได้การเชื่อมต่อที่สมบูรณ์แบบระหว่าง BGA และ PCB การเชื่อมต่อประเภทนี้มีคุณสมบัติเด่นด้านการนำความร้อนและสมรรถนะทางไฟฟ้าที่ยอดเยี่ยม นอกจากนี้ CBGA ยังมีความน่าเชื่อถือสูงมากแต่มีต้นทุนสูง ดังนั้น แพ็กเกจ CBGA จึงเหมาะสมกว่าในการใช้งานด้านยานยนต์หรือชิปประสิทธิภาพสูง
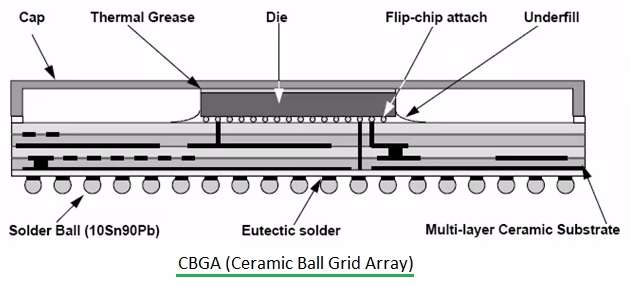
อ้างอิงภาพจากโลกแห่งการทดสอบและการวัดผล
• TBGA
TBGA ซึ่งย่อมาจาก tape ball grid array สามารถลดความหนาของแพ็กเกจได้อย่างมีประสิทธิภาพและให้สมรรถนะทางไฟฟ้าที่ดีเยี่ยม นอกจากนี้ ยังให้ผลการระบายความร้อนได้อย่างยอดเยี่ยมเมื่อมีการใช้ฮีตซิงก์และการออกแบบให้ชิปหันหน้าลง ดังนั้น TBGA จึงเหมาะอย่างยิ่งสำหรับผลิตภัณฑ์ประสิทธิภาพสูงที่ต้องการแพ็กเกจบาง สำหรับชิปที่หันหน้าลงควรเลือกใช้เทคโนโลยีฟลิปชิป ในขณะที่สำหรับชิปที่หันหน้าขึ้นควรเลือกใช้การเชื่อมต่อแบบลวด โดยทั่วไปแล้ว TBGA มีต้นทุนสูงกว่า PBGA
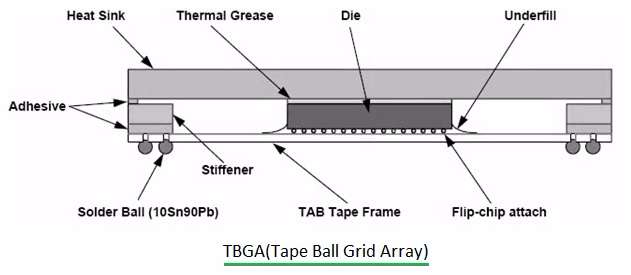
อ้างอิงภาพจากโลกแห่งการทดสอบและการวัดผล
• EBGA
EBGA (thermal enhanced ball grid array) เป็นรูปแบบหนึ่งของ PBGA โดยมีความแตกต่างด้านโครงสร้างเพียงอย่างเดียวคือมีการเพิ่มฮีทซิงก์เข้าไป ชิปจะถูกยึดติดโดยตรงกับฮีทซิงก์ในลักษณะคว่ำหน้าลง และการเชื่อมต่อทางไฟฟ้าระหว่างชิปกับแผ่น PCB จะทำผ่านการบอนด์ด้วยลวด วิธีการซีลมีดังนี้: สร้างแนวกั้น (dam) บนซับสเตรตล้อมรอบชิป จากนั้นจึงใช้สารประกอบเหลวในการหุ้ม ตัวอย่างในภาพด้านล่างเป็นตัวอย่างที่ดีของ EBGA

อ้างอิงภาพจากส่วนประกอบเชิงปฏิบัติ
• FC-BGA
FC-BGA เป็นคำย่อของ flip chip ball grid array ซึ่งมีโครงสร้างคล้ายกับ CBGA แต่ใช้เรซิน BT แทนซับสเตรตเซรามิก ทำให้ FC-BGA ประหยัดต้นทุนได้มากกว่า นอกจากนี้ flip chip ยังสามารถย่นระยะทางของวงจรภายใน ช่วยปรับปรุงสมรรถนะทางไฟฟ้าได้อย่างมีประสิทธิภาพ วัสดุที่ใช้ทำเมทัลบัมพ์ในเทคโนโลยี flip chip ส่วนใหญ่จะใช้ดีบุกและตะกั่วในอัตราส่วน 63:37 เพื่อให้วัสดุชนิดนี้มีแรงตึงผิวสูงเมื่ออยู่ในสถานะหลอมเหลว ส่งผลให้ชิปสามารถถูกดึงไปยังตำแหน่งที่ถูกต้องได้โดยไม่จำเป็นต้องใช้เครื่องจัดแนว flip chip ที่มีความแม่นยำสูง
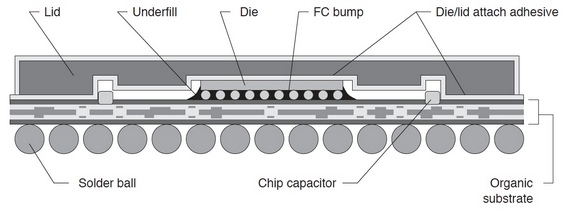
อ้างอิงภาพจากShipco Circuits
• MBGA
MBGA ซึ่งย่อมาจาก metal ball grid array ได้รับการพัฒนาโดย Olin โดยใช้เมทัลเซรามิกเป็นวัสดุฐาน แผงวงจรบนวัสดุฐานถูกผลิตขึ้นผ่านกระบวนการเคลือบแบบสปัตเตอริง โดยให้ด้านชิปหันลงด้านล่างและใช้การเชื่อมลวดเป็นการเชื่อมต่อภายใน MBGA ยังสามารถมอบสมรรถนะทางไฟฟ้าที่ยอดเยี่ยมและประสิทธิภาพการกระจายความร้อนได้เป็นอย่างดี
• ไมโคร BGA
Micro BGA เป็นรูปแบบแพ็กเกจชนิดหนึ่งที่มีขนาดเทียบเท่ากับชิป พัฒนาโดยบริษัท Tessera Micro BGA ทำงานโดยให้ด้านชิปหันลงด้านล่างและใช้เทปบรรจุภัณฑ์เป็นซับสเตรต มีการวางชั้นอีลาสโตเมอร์ระหว่างชิปกับเทปเพื่อช่วยลดความเค้นที่เกิดจากการขยายตัวเนื่องจากความร้อน การเชื่อมต่อระหว่างเทปกับชิปใช้ประโยชน์จากขาเงินพิเศษที่ชุบทอง ในขณะที่การเชื่อมต่อระหว่างเมนบอร์ดกับสภาพแวดล้อมภายนอกทำได้ผ่าน BGA ข้อดีที่สำคัญของ Micro BGA อยู่ที่ความมีขนาดเล็กและน้ำหนักเบา ซึ่งทำให้ถูกนำไปใช้อย่างแพร่หลายในผลิตภัณฑ์ที่มีข้อจำกัดด้านพื้นที่ นอกจากนี้ยังเหมาะอย่างยิ่งสำหรับผลิตภัณฑ์จัดเก็บข้อมูลที่มีจำนวนขาน้อยอีกด้วย
ต้องการชิ้นส่วน BGA อยู่หรือไม่? PCBCart ช่วยจัดหาทั้งหมดให้คุณได้ในราคายุติธรรม
ในเมื่อปัจจุบันมีการจำแนกประเภทของ BGA อยู่มากมาย การเลือกใช้แพ็กเกจ BGA ที่เหมาะสมที่สุดจึงควรพิจารณาจากคุณสมบัติของผลิตภัณฑ์ขั้นสุดท้ายของคุณ ข้อจำกัดด้านต้นทุน รวมถึงสมรรถนะและฟังก์ชันการทำงานที่คาดหวัง ทีมจัดซื้อของ PCBCart ให้คำแนะนำอย่างมืออาชีพเกี่ยวกับประเภทของชิ้นส่วน BGA ที่เหมาะสมที่สุด โดยคำนึงถึงปัจจัยข้างต้นอย่างรอบด้าน นอกจากนี้ ชิ้นส่วนทั้งหมด 100% จะต้องได้รับการตรวจสอบก่อนนำไปใช้งาน เพื่อให้มั่นใจว่าสมรรถนะที่สมบูรณ์แบบจะถูกส่งมอบในผลิตภัณฑ์ขั้นสุดท้ายติดต่อเราเพื่อขอใบเสนอราคาฟรี!
ขอใบเสนอราคาประกอบบีจีเอของคุณตอนนี้
แหล่งข้อมูลที่เป็นประโยชน์
•สี่ขั้นตอนในการรู้จัก BGA
•บทนำเกี่ยวกับเทคโนโลยีการบรรจุภัณฑ์แบบ BGA
•ปัจจัยที่มีผลต่อคุณภาพของการประกอบ BGA
•ข้อกำหนดเกี่ยวกับไฟล์ออกแบบเพื่อให้มั่นใจในการประกอบ BGA อย่างมีประสิทธิภาพ
•วิธีขอใบเสนอราคาที่แม่นยำสำหรับความต้องการประกอบ BGA ของคุณ