La tecnologia SMT (surface mount technology) è presentata in relazione alla tradizionale THT (through hole technology). Rispetto all’assemblaggio THT, l’assemblaggio SMT consente un risparmio di spazio dal 60% al 70% e una riduzione di peso dal 70% all’80%, poiché permette di saldare direttamente i componenti elettronici su entrambi i lati del PCB (printed circuit board) senza necessità di foratura. Pertanto, l’assemblaggio SMT svolge un ruolo significativo nell’accelerare la miniaturizzazione, la leggerezza e la sottigliezza dei prodotti elettronici, il che deriva in particolare dalla tecnologia SMT a passo fine (pitch inferiore a 0,65 mm). La tendenza di sviluppo sopra menzionata è chiaramente riscontrabile in telefoni cellulari, PC e videocamere. Gli SMD (surface mount devices) sono una tipologia di componenti senza terminali o con terminali corti, come SOP (small outline package), LCC (leadless chip carrier), PLCC (plastic leadless chip carrier), SOJ (small outline j-lead) package, SOIC (small outline integrated circuit) e QFP (quad flat package), tra i quali il QFP rappresenta la maggior parte delle applicazioni.
Tuttavia, con lo sviluppo dei circuiti integrati (IC, integrated circuit), si punta a ottenere un numero sempre maggiore di funzioni e di pin di I/O. Inoltre, le persone mantengono requisiti sempre più elevati per quanto riguarda la miniaturizzazione dei prodotti elettronici. Pertanto, l’applicazione della tradizionale tecnologia di packaging SMT non è più adeguata, ad esempio tramite l’uso della tecnologia QFP, l’aumento dei pin di I/O e la riduzione del passo. I terminali del QFP sono distribuiti linearmente e la riduzione del passo dei terminali è già prossima a un limite. Con il numero di pin di I/O in costante aumento, non è facile continuare a migliorare le funzionalità dei prodotti elettronici riducendone al contempo il volume e rendendoli elettricamente ragionevoli ed efficienti. Per risolvere questo problema, un altro tipo di package, ovvero la tecnologia di packaging BGA (ball grid array), è in grado di risolvere efficacemente la questione e ha ottenuto importanti progressi nella produzione e nell’applicazione.
Il confronto tra la tecnologia di packaging BGA e la tradizionale SMT/SMD può essere effettuato dai seguenti punti di vista.
• Confronto sulla struttura del lead
Il confronto tra la tecnologia di packaging BGA e la tradizionale SMT/SMD in termini di struttura dei terminali può essere riassunto nella seguente tabella.
|
Articoli
|
Ala di gabbiano
|
Responsabile J
|
Io guido
|
BGA
|
| Capacità di adattare package multilead |
Buono |
Ordinario |
Ordinario |
Eccellente |
| Spessore della confezione |
Buono |
Ordinario |
Ordinario |
Eccellente |
| Rigidità del conduttore |
Ordinario |
Buono |
Ordinario |
Eccellente |
| Capacità di adattarsi alla saldatura multipla |
Eccellente |
Ordinario |
Ordinario |
Ordinario |
| Capacità di autoallineamento nella saldatura a rifusione |
Buono |
Ordinario |
Ordinario |
Eccellente |
| Possibilità di essere ispezionato dopo la saldatura |
Ordinario |
Buono |
Ordinario |
Ordinario |
| Difficoltà di pulizia |
Ordinario |
Buono |
Eccellente |
Ordinario |
| Utilizzo efficace dell'area |
Ordinario |
Buono |
Ordinario |
Eccellente |
• Confronto sulle dimensioni del pacchetto
Tre tipi di pacchetti sono utilizzati come esempi di confronto, con i relativi parametri riportati nella Tabella 2 qui sotto.
|
Pacchetto
|
Conteggio lead
|
Passo (mm)
|
Dimensioni confezione (mm)
|
| BGA |
625 |
1,27 |
32*32 |
| TAB |
608 |
0,25 |
44*49 |
| PQFP |
304 |
0,5 |
46*46 |
Sulla base del confronto dei parametri indicato nella tabella sopra, è evidente che il BGA presenta il maggior numero di terminali e le dimensioni di package più ridotte.
• Confronto della densità di assemblaggio tra tutti i tipi di strutture di package
Il confronto della densità di assemblaggio tra tutti i tipi di strutture di package è riassunto nella Tabella 3 seguente.
|
Pacchetto
|
Passo (mm)
|
Dimensioni (mm)
|
Conteggio pin I/O
|
| BGA |
1,27 |
32,5*32,5 |
625 |
| FPD |
0,50 |
32,5*32,5 |
240 |
| UFPD |
0,40 |
32,5*32,5 |
296 |
| UFPD |
0,30 |
32,5*32,5 |
408 |
| TCP |
0,25 |
32,5*32,5 |
480 |
| TCP |
0,20 |
32,5*32,5 |
600 |
• Procedura di assemblaggio
La tecnologia di packaging BGA fa sì che il tradizionale package SMT si espanda con i vantaggi di un SMT potenziato. Per quanto riguarda i componenti a passo fine o i componenti con package BGA, essi condividono procedure di assemblaggio simili, illustrate nella figura seguente.
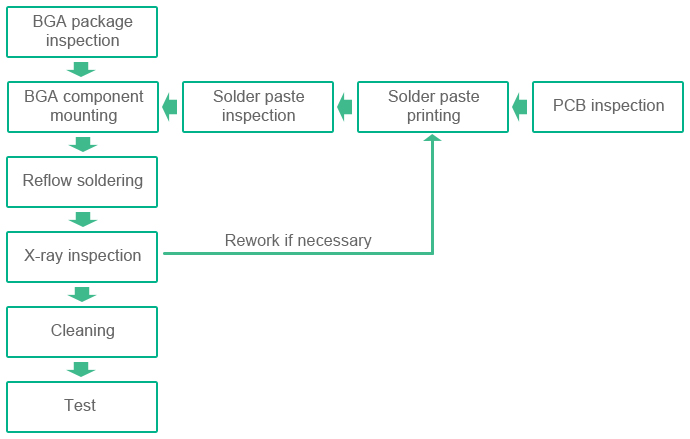
• Tasso di difetti di assemblaggio
Per quanto riguarda il tasso di difetti di assemblaggio di BGA e QFP, grazie a oltre 20 anni di esperienza di assemblaggio accumulata lungo la linea di produzione di PCBCart, si può concludere cheIl BGA presenta un tasso di difetti inferiore e una migliore producibilitàrispetto al QFP.
• Ispezione finale
Rispetto all’ispezione della pasta saldante BGA, il QFP a passo fine comporta costi aggiuntivi a causa della sua ispezione di affidabilità. In base alle caratteristiche dei difetti, si dovrebbe generalmente applicare un sistema automatico per l’ispezione dei cortocircuiti o dei circuiti aperti, il che aumenta i costi di produzione del QFP. Poiché i package BGA sono caratterizzati da un’elevata efficienza produttiva e da un basso tasso di difetti, la loro ispezione si concentra solo sull’allineamento e sul posizionamento.
• Rielaborazione
Il costo di rilavorazione dei package BGA è molto più elevato rispetto a quello dei QFP per i seguenti motivi:
a.Poiché è quasi impossibile apportare modifiche per eliminare un singolo cortocircuito o un circuito aperto, l’eliminazione di tutti i difetti di assemblaggio relativi ai package BGA deve dipendere dal rework.
b.Il rework dei package BGA è più difficile rispetto a quello dei QFP e il rework può richiedere più attrezzature e un aumento dei costi.
c.I componenti BGA dopo il rework non funzionano mai, mentre alcuni componenti QFP possono ancora essere utilizzati purché vengano dissaldati con attenzione.
Per quanto riguarda il confronto tra BGA e SMT tradizionale in termini di tecnologia di rilavorazione, si può concludere che la rilavorazione dei package BGA deve essere eseguita con un preriscaldamento completamente totale. I componenti BGA condividono una temperatura di preriscaldamento simile a quella di altri tipi di SMD, ma richiedono una diversa velocità di aumento della temperatura di preriscaldamento. I componenti BGA devono essere riscaldati gradualmente con una curva di preriscaldamento uniforme.
Inoltre, tutte le sferette di saldatura sotto i package BGA devono essere riscaldate simultaneamente. La pasta saldante per i package BGA deve essere applicata in modo rigoroso e non è consentito apportare modifiche ai giunti di saldatura. Inoltre, i componenti in package BGA possono essere applicati comodamente grazie al loro ampio passo.
• Posizioni di saldatura riservate
La principale differenza tra BGA e QFP in termini di posizioni di saldatura riservate risiede nel fatto che si tratta rispettivamente di una matrice nascosta e di terminali nascosti. Per quanto riguarda il miglioramento delle capacità di progettazione PCB, tutti i tipi di package presentano i propri vantaggi, ma la questione più fondamentale riguarda la densità delle tracce, l’attività delle tracce e le prestazioni complessive.
Poiché i package BGA offrono buone prestazioni di dissipazione termica, anche se il file di progettazione del PCB prevede uno spazio ridotto tra i componenti termici, i package BGA possono comunque fornire un ambiente di funzionamento con una buona capacità di dissipazione del calore.
• Affidabilità delle giunzioni di saldatura
L’affidabilità delle giunzioni di saldatura e il tasso di assemblaggio sono influenzati da quattro elementi: saldabilità della scheda, prestazioni di saldatura dei componenti, coplanarità dei componenti e volume della pasta saldante, tutti fattori che determinano la qualità dei prodotti finali.
In quanto nuovo tipo di tecnologia di packaging microelettronico, il BGA sostituirà sicuramente il QFP per soddisfare i nuovi requisiti di multifunzionalità e di elevato numero di pin di I/O.
In qualità di assemblatore professionale di PCB con oltre 20 anni di esperienza, PCBCart è in grado di gestire l’assemblaggio di componenti elettronici con diversi tipi di package, tra cui BGA, QFN, QFP, CSP, WLCSP ecc. Gli SMD che possono essere assemblati nell’officina PCBCart partono dal formato 01005 e il passo minimo dei BGA può essere di 0,4 mm, mentre quello dei WLCSP è di 0,35 mm, in modo da essere compatibile con la tendenza alla miniaturizzazione dell’elettronica moderna. Non esitare a contattarci per maggiori dettagli sui nostriAssemblaggio PCB avanzatoservizio. Il preventivo è sempre gratuito ed è il benvenuto!
Risorse utili:
•Consigli imperdibili di layout per chip BGA
•Fattori che influenzano la qualità dell’assemblaggio BGA
•Elementi da considerare attentamente sulla capacità del processo di assemblaggio BGA
•PCBCart è specializzata nella gestione di molteplici tipi di package di componenti come BGA, PBGA, Flip Chip, CSP e WLCSP