電子技術の継続的な発展と進歩に伴い、電子製品は軽量化、薄型化、小型化および高機能化の方向へと発展し始めている。世代交代を経た結果、チップ面積とパッケージ面積の比率はほぼ1となり、その中でもBGA(ボール・グリッド・アレイ)は、実用段階に入った高密度実装技術となっている。BGAのはんだ付け品質の信頼性をいかに確保するか、BGAの品質をいかに検査するか、そして欠陥のあるBGAに対していかにリワークを行うかは、BGAにとって極めて重要である。SMT(表面実装技術)実装すべての製造業者は、本記事で論じられる自社の決議事項を完全に把握していなければならない。
BGAパッケージング技術
BGAパッケージは、チューブの底面または上面に多数の球状バンプを有しています。これらのバンプのおかげで、パッケージ本体と基板との間の接続が実現されます。先進的なパッケージング技術として、BGAは、パッケージ本体の底面にボールまたはカラムとして機能するI/O端子を分散配置することで、大きなリード間隔と短いリードという特長を備えています。
異なるパッケージ材料に基づき、BGA部品は PBGA(プラスチックBGA)、CBGA(セラミックBGA)、CCBGA(セラミックカラムBGA)、TBGA(テープBGA)および CSP(チップスケールパッケージ)に分類されます。
QFP(クワッド・フラット・パッケージ)部品と比較して、BGA部品には次のような特性があります。
a. I/O端のピッチが大きいため、BGAではより多くのI/O端子を収容することができる。
b. より高いパッケージ信頼性、より少ないはんだ付け不良、そしてより強固なはんだ接合部。
c. BGAチップは、アライメント拡大システムにより位置合わせが容易で、はんだ付け部同士の間隔も広いため、位置合わせやはんだ付けが難しくありません。
d. BGA はんだ付けの共面性は、はんだが溶融後にチップと PCB 間の平面度誤差を自動的に補正するため、保証されます。
e. はんだ付け部が小さく、自己インダクタンスおよび相互インダクタンスが低いため、優れた電気特性および周波数特性を有します。
f. はんだ付け接合部間で自動的な自己アライメントおよび張力調整が可能であり、優れたセルフセンタリング効果をもたらし、高い信頼性を実現します。
g. 主な欠点は、検査および手直しの実施が比較的困難である点にある。
懸念される要素を示すフィッシュボーン図PCB基板の製造工程以下に、BGA コンポーネントを含むものを示します。
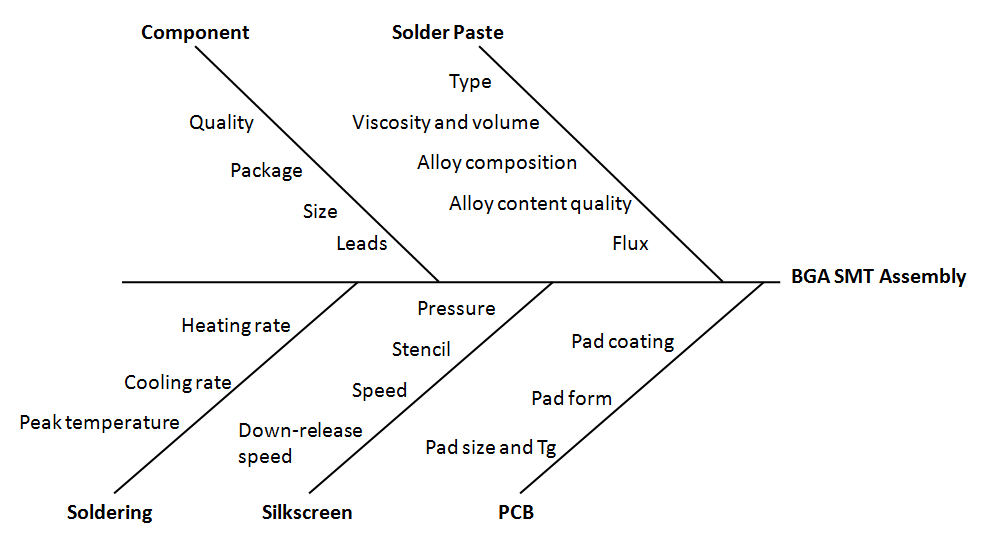
上記のフィッシュボーンによると、BGA SMT ははんだペースト、部品、PCB、シルク印刷およびはんだ付けと密接に関連しており、その中でもリフローはんだ付け工程で最も対処が難しいのははんだ付け項目です。
リフローはんだ付けに影響を与える重要な要素は、温度プロファイルの設定にある。具体的な方法としては、PCB裏面側のBGA中央部に位置する一部のパッド位置に穴を開け、そこから熱電対プローブをPCB基板の下面から通し、パッド裏面に密着させて高耐熱テープで固定する。次に、パラメータを適切に設定したリフローはんだ付け用温度プロファイルテスターを、トレイおよびプローブとともにリフロー炉内に投入する。複数回の比較・解析を行った後、最適な温度プロファイルが得られる。
リフロー温度曲線は、予熱工程、温度保持工程、リフロー工程および冷却工程の4つのフェーズから構成される。加熱プロセスおよび温度曲線は、パッケージがリフロー温度に到達した後、はんだボールが溶融してパッドとの間に金属間化合物が生成された状態で、温度がパッドの温度まで戻るようにしなければならない。不均一な加熱は、リフローはんだ付け時にパッケージが不均一に沈み込んだり、一方の側またはコーナー側に傾いたりする原因となり、平面度不良やはんだ付け不良を引き起こす。
BGAはんだ付けに関しては、次の2点も強調する必要があります。
a. 予備焼成
プラスチックパッケージは通常、湿気を吸収します。チップが空気中の湿気を吸収した直後に急激に加熱されると、水分の拡散によってチップ内部に空洞が生じます。その結果、プラスチックパッケージの一般的なベーキング条件は、100°C未満で6~8時間となります。
b. 酸化
BGAコンポーネントを実装する前に、ピンが清浄であり、酸化が一切発生していないことを確認するための検査を行う必要があります。
BGA検査方法
a. BGAの欠陥と検査方法
はんだ付け後、BGA部品は部品自体、実装装置、環境、はんだ付け技術などに起因してさまざまな欠陥を生じる可能性があります。代表的なBGAの欠陥には、位置ずれ、はんだ不良、オープン回路、コールドジョイント、ブリッジ、短絡およびボイドなどがあります。さらに、BGAのはんだボール自体にも、欠落・脱落、不均一なサイズといった問題が発生する可能性があります。
BGAの検査に関しては、はんだボールがチップの下にあるため、はんだ付け後にその品質を判断するのは非常に困難です。従来の目視検査では、はんだ接合部内部に欠陥やボイドが存在するかどうかを判定することはできません。はんだ接合部の品質を明確に評価するためには、専用の検査装置を使用する必要があります。
SMT実装でBGA部品が使用されるようになると、通常用いられる検査方法には、電気的試験、バウンダリスキャン、およびX線検査が含まれる。従来の電気的試験は、開放回路および短絡不良を検出することができる。バウンダリスキャン技術は、バウンダリスキャンに基づいて設計された検査ポートに依存しており、バウンダリコネクタ上の各はんだ接合部へのアクセスを提供することで、部品上の開放回路および短絡を検査できる。バウンダリスキャンは電気的試験よりも広範囲の不可視はんだ接合部を検査できるものの、どちらの方法も電気的性能のみを試験するものであり、はんだ付け品質の検査には至らない。製造プロセスの品質を保証し、向上させるためには、特にこれらの不可視はんだ接合部のはんだ付け品質検査において、他の方法に依存する必要がある。AXI(自動X線検査)問題を効果的に解決できるだけでなく、品質を確保し、プロセス制御のためのリアルタイムなフィードバックを行うために、リアルタイム監視も実施することができます。
b. 最適なBGAはんだ接合部規格
最適なBGAはんだ接合部は、表面が滑らかで、境界が明瞭で、ボイドがなく、直径・体積・グレースケール値・コントラストがすべてのはんだ接合部間で同一に保たれ、完全に位置合わせされており、はんだボールが発生していない状態である必要があります。最適なBGAはんだ接合部に関する規格と比較すると、合格品レベルのBGAはんだ接合部に対する要求はそれよりも低くなります。
・ミスアラインメントX線検査装置は、BGAはんだボールがPCB基板上のパッド位置と正確に一致しているかどうかを明確に示すことができます。25%未満のずれであれば許容されます。
・はんだ付け不良の接合部・BGAはんだ付けにおいて、はんだ付け不良(ルーズなはんだ接合部)は一切許可されません。
・開放回路およびコールドはんだ接合部はんだが対応するパッドに接触していない場合や、はんだの濡れ性が悪い場合、オープン回路やコールドはんだ不良が発生する可能性があります。BGA はんだ付けにおいては、オープン回路およびコールドはんだ不良は許容されません。
・ブリッジングおよび短絡はんだが過剰であったり不適切な位置に配置された場合、ブリッジや短絡が発生する可能性があります。BGA はんだ接合部については、ブリッジおよび短絡は許容されません。
・虫歯・キャビティに関する問題はやや複雑です。X線検査装置は、BGA部品の実装におけるキャビティを確認することができます。以下のポイントは、判定基準として利用できます。
1). キャビティ発生の原因
① BGAはんだボールをはんだ付けする前の段階で空洞が存在しており、これははんだボールの製造工程、またははんだペーストの成分に起因している可能性があります。
② スルーホールがパッドの下に設計されている場合、外部の空気がスルーホールを通って溶融したはんだボール内に入り、冷却後に空洞が形成されます。
③ パッドの特性が不良なコーティングである、またはパッド表面に汚染物が付着している。
④ リフローはんだ付けの温度カーブが不適切に設定されている。
2). 虫歯に対する最適な基準
空洞内の空気は、収縮および膨張による応力効果を生じる可能性があります。空洞が発生する箇所は応力集中部となり、これが応力クラックの本質的な原因となる可能性があります。空洞を有するBGAはんだ接合部は、故障などの技術的問題を引き起こす可能性があります。BGAはんだ接合部に関するIPC規格によれば、パッド上の空洞ははんだボール面積の10%を超えてはならず、つまり空洞の直径ははんだボール直径の30%を超えてはならないとされています。
PCBCart から認定済みの BGA SMT 実装サービスを入手する
世界有数のPCB実装メーカーの一つとして、PCBCartは、IPC規格に準拠したフルスケールの自動SMT実装サービスを提供しています。SMT実装で20年以上の経験があるため、現在ではピッチが0.4mmまでのBGA部品にも対応することができます。弊社のBGA実装能力の詳細については、どうぞお問い合わせまたは、以下のボタンをクリックして、BGA SMTアセンブリのご要望に関するお見積もり依頼を送信することもできます。完全に無料です!
無料BGA SMT実装お見積りのご依頼
役立つリソース
•BGAを理解するための4つのステップ
•BGAパッケージング技術の概要
•BGA実装の品質に影響を与える要因
•効率的なBGA実装を確保するための設計ファイル要件
•BGA実装のご要望に対して正確な見積もりを取得する方法














