ด้วยการพัฒนาและความก้าวหน้าอย่างต่อเนื่องของเทคโนโลยีอิเล็กทรอนิกส์ ผลิตภัณฑ์อิเล็กทรอนิกส์เริ่มพัฒนาไปสู่แนวโน้มที่มีน้ำหนักเบา บาง ขนาดเล็ก และมีฟังก์ชันขั้นสูง หลังจากการอัปเกรดมาหลายรุ่น เทคโนโลยีการแพ็กเกจชิปทำให้อัตราส่วนระหว่างพื้นที่ชิปกับพื้นที่แพ็กเกจมีค่าใกล้เคียง 1 ซึ่งในบรรดานั้น BGA (ball grid array) ได้กลายเป็นเทคโนโลยีการแพ็กเกจความหนาแน่นสูงที่เข้าสู่ระยะการใช้งานจริงแล้ว วิธีการรับประกันความน่าเชื่อถือของคุณภาพการบัดกรี BGA วิธีการตรวจสอบคุณภาพของ BGA และวิธีการทำการรีเวิร์กกับ BGA ที่มีข้อบกพร่อง ล้วนเป็นประเด็นที่สำคัญอย่างยิ่งต่อ BGAการประกอบ SMT (เทคโนโลยีการติดตั้งบนพื้นผิว)ที่ผู้ผลิตทุกรายจำเป็นต้องตระหนักอย่างถ่องแท้ถึงมติของตน ซึ่งจะมีการกล่าวถึงในบทความนี้
เทคโนโลยีการบรรจุภัณฑ์แบบ BGA
แพ็กเกจ BGA มีปุ่มนูนทรงกลมจำนวนมากที่ด้านล่างของตัวแพ็กเกจหรือที่ผิวด้านบน ด้วยปุ่มนูนเหล่านี้จึงทำให้เกิดการเชื่อมต่อระหว่างตัวแพ็กเกจกับฐาน ในฐานะเทคโนโลยีการบรรจุขั้นสูง BGA มีลักษณะเด่นคือระยะห่างระหว่างขาเชื่อมต่อที่กว้างและความยาวขาที่สั้น โดยการกระจายขั้ว I/O ซึ่งทำหน้าที่เป็นลูกบอลหรือคอลัมน์ไว้ที่ด้านล่างของตัวแพ็กเกจ
ตามวัสดุบรรจุภัณฑ์ที่แตกต่างกัน ส่วนประกอบ BGA สามารถแบ่งออกได้เป็น PBGA (plastic BGA), CBGA (ceramic BGA), CCBGA (ceramic column BGA), TBGA (tape BGA) และ CSP (chip-scale package)
เมื่อเปรียบเทียบกับคอมโพเนนต์แบบ QFP (quad flat package) แล้ว คอมโพเนนต์แบบ BGA มีคุณสมบัติดังต่อไปนี้:
a. ระยะห่างระหว่างขา I/O มีขนาดใหญ่จนทำให้ BGA สามารถรองรับจำนวนขา I/O ที่มากขึ้นได้
b. ความน่าเชื่อถือของบรรจุภัณฑ์สูงขึ้น ข้อบกพร่องในการบัดกรีลดลง และรอยต่อการบัดกรีมีความแข็งแรงมากขึ้น
c. ชิป BGA มีระยะห่างระหว่างจุดบัดกรีค่อนข้างมาก ทำให้การจัดแนวและการบัดกรีไม่ยาก เนื่องจากมีระบบขยายการจัดแนว
d. ความระนาบร่วมของการบัดกรีแบบ BGA ได้รับการรับประกัน เนื่องจากบัดกรีจะชดเชยความคลาดเคลื่อนของความระนาบระหว่างชิปและแผงวงจรพิมพ์ (PCB) โดยอัตโนมัติหลังจากหลอมละลายแล้ว
e. มีคุณลักษณะทางไฟฟ้าและคุณลักษณะด้านความถี่ที่ยอดเยี่ยมเนื่องจากจุดบัดกรีที่มีขนาดเล็กลงและมีค่าความเหนี่ยวนำตัวเองและความเหนี่ยวนำร่วมต่ำ
f. สามารถปรับแนวอัตโนมัติและควบคุมความตึงระหว่างข้อต่อบัดกรีได้อย่างมีประสิทธิภาพ ทำให้เกิดผลในการจัดศูนย์ตัวเองที่ยอดเยี่ยม ส่งผลให้มีความน่าเชื่อถือสูง
g. ข้อเสียหลักของมันอยู่ที่การตรวจสอบและการทำงานแก้ไขซึ่งค่อนข้างทำได้ยาก
แผนผังก้างปลาแสดงองค์ประกอบที่น่ากังวลในกระบวนการผลิตแผ่นวงจรพิมพ์ (PCB)ที่มีส่วนประกอบ BGA แสดงไว้ด้านล่าง
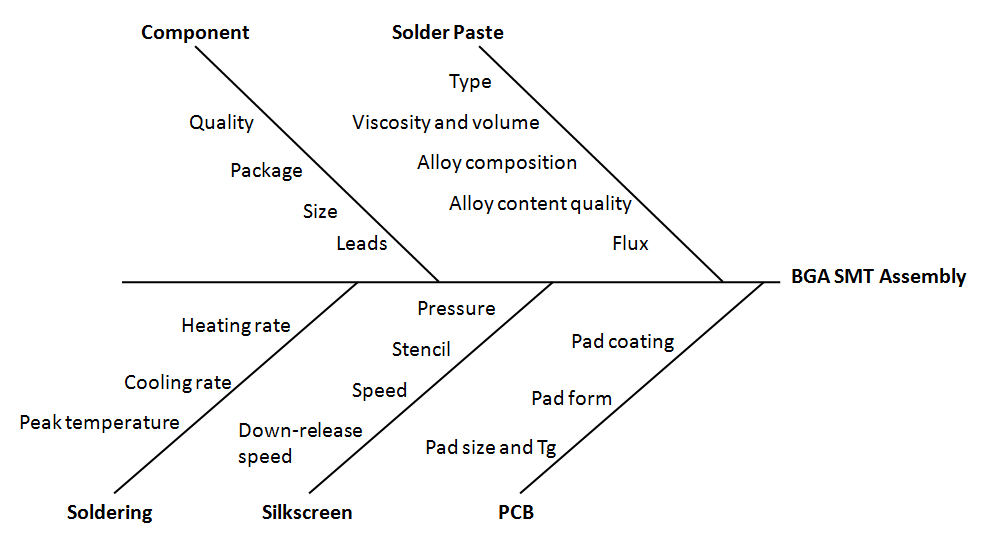
ตามไดอะแกรมก้างปลาข้างต้น BGA SMT มีความเกี่ยวข้องอย่างใกล้ชิดกับครีมประสาน (solder paste) ชิ้นส่วน (components) แผ่นวงจรพิมพ์ (PCB) ซิลค์สกรีน และการบัดกรี ซึ่งในบรรดาปัจจัยเหล่านี้ รายการที่เกี่ยวกับการบัดกรีเป็นส่วนที่จัดการได้ยากที่สุดในกระบวนการบัดกรีแบบรีโฟลว์
องค์ประกอบสำคัญที่มีผลต่อการรีโฟลว์บัดกรีอยู่ที่การตั้งค่าเส้นโค้งอุณหภูมิ วิธีการเฉพาะคือการเจาะรูที่ตำแหน่งของแผ่นรองบางจุดบริเวณกึ่งกลางของ BGA ที่อยู่ด้านหลังของแผ่น PCB จากนั้นสอดโพรบเทอร์โมคัปเปิลผ่านรูจากด้านล่างของแผ่น PCB โดยให้โพรบแนบติดกับด้านหลังของแผ่นรองและยึดด้วยเทปทนความร้อน จากนั้นนำเครื่องทดสอบเส้นโค้งอุณหภูมิสำหรับการรีโฟลว์บัดกรีที่ตั้งค่าพารามิเตอร์เรียบร้อยแล้ว ใส่เข้าไปในเตารีโฟลว์บัดกรีพร้อมกับถาดและโพรบ หลังจากทำการเปรียบเทียบและวิเคราะห์หลายครั้ง จะได้เส้นโค้งอุณหภูมิที่เหมาะสมที่สุด
เส้นโค้งอุณหภูมิการรีโฟลว์ประกอบด้วย 4 ระยะ ได้แก่ ระยะอุ่นล่วงหน้า ระยะคงอุณหภูมิ ระยะรีโฟลว์ และระยะทำให้เย็นลง กระบวนการให้ความร้อนและเส้นโค้งอุณหภูมิควรทำให้แพ็กเกจมีอุณหภูมิถึงจุดรีโฟลว์แล้วจึงลดลงกลับสู่ระดับของแผ่นรอง หลังจากที่ลูกบอลประสานหลอมละลายและเกิดสารประกอบโลหะผสมระหว่างโลหะกับแผ่นรองแล้ว การให้ความร้อนไม่สม่ำเสมอจะทำให้แพ็กเกจตกลงไม่เท่ากันหรือเอียงไปทางด้านใดด้านหนึ่งหรือมุมใดมุมหนึ่งระหว่างการบัดกรีแบบรีโฟลว์ ส่งผลให้ระนาบไม่เสมอกันและการบัดกรีไม่เพียงพอ
ในด้านการบัดกรี BGA ควรให้ความสำคัญกับสองประเด็นต่อไปนี้ด้วย:
a. การอบล่วงหน้า
บรรจุภัณฑ์พลาสติกมักดูดซับความชื้น หากชิปถูกให้ความร้อนทันทีหลังจากดูดซับความชื้นในอากาศ การแพร่กระจายของความชื้นจะทำให้เกิดโพรงภายในชิป ดังนั้น เงื่อนไขการอบทั่วไปของบรรจุภัณฑ์พลาสติกจึงอยู่ที่อุณหภูมิต่ำกว่า 100°C เป็นเวลา 6 ถึง 8 ชั่วโมง
b. การเกิดออกซิเดชัน
ก่อนนำไปใช้งาน ควรตรวจสอบชิ้นส่วน BGA เพื่อให้แน่ใจว่าขาของมันสะอาดและไม่มีการเกิดออกซิเดชัน
วิธีการตรวจสอบ BGA
a. ข้อบกพร่องของ BGA และวิธีการตรวจสอบ
หลังการบัดกรี ส่วนประกอบ BGA อาจเกิดข้อบกพร่องต่าง ๆ ได้เนื่องมาจากตัวชิ้นส่วน อุปกรณ์การประกอบ สภาพแวดล้อม และเทคโนโลยีการบัดกรี ข้อบกพร่องหลักของ BGA ได้แก่ การเยื้องศูนย์ การบัดกรีไม่แน่น วงจรเปิด การบัดกรีเย็น การเชื่อมติดกัน การลัดวงจร และโพรงอากาศ นอกจากนี้ ลูกบอลบัดกรีของ BGA เองก็อาจมีปัญหาได้เช่นกัน เช่น ลูกบอลหาย หลุดร่วง หรือมีขนาดไม่สม่ำเสมอ
เมื่อพูดถึงการตรวจสอบ BGA การประเมินคุณภาพการบัดกรีหลังการบัดกรีทำได้ยากมาก เนื่องจากลูกบอลบัดกรีอยู่ใต้ชิป การตรวจสอบด้วยสายตาแบบดั้งเดิมไม่สามารถระบุได้ว่ามีข้อบกพร่องหรือโพรงอากาศภายในข้อต่อบัดกรีหรือไม่ จึงจำเป็นต้องใช้อุปกรณ์ตรวจสอบเฉพาะทางเพื่อประเมินคุณภาพของข้อต่อบัดกรีอย่างชัดเจน
หลังจากมีการใช้ชิ้นส่วน BGA ในการประกอบ SMT แล้ว วิธีการตรวจสอบที่มักใช้งานได้แก่ การทดสอบทางไฟฟ้า การสแกนขอบเขต (boundary scan) และการตรวจสอบด้วยเอกซเรย์ การทดสอบทางไฟฟ้าแบบดั้งเดิมสามารถตรวจหาข้อบกพร่องวงจรเปิดและวงจรลัดได้ เทคโนโลยีการสแกนขอบเขต ซึ่งอาศัยพอร์ตตรวจสอบที่ออกแบบบนพื้นฐานของการสแกนขอบเขต ช่วยให้สามารถเข้าถึงจุดบัดกรีแต่ละจุดบนขั้วต่อขอบเขตได้ ทำให้สามารถตรวจสอบวงจรเปิดและวงจรลัดบนชิ้นส่วนได้ แม้ว่าการสแกนขอบเขตจะสามารถตรวจสอบจุดบัดกรีที่มองไม่เห็นได้ในช่วงที่กว้างกว่าการทดสอบทางไฟฟ้า แต่วิธีการทั้งสองนี้ตรวจสอบได้เพียงสมรรถนะทางไฟฟ้าโดยไม่ครอบคลุมถึงการตรวจสอบคุณภาพการบัดกรี เพื่อให้มั่นใจและปรับปรุงคุณภาพของกระบวนการผลิต จึงจำเป็นต้องพึ่งพาวิธีการอื่นสำหรับการตรวจสอบคุณภาพการบัดกรี โดยเฉพาะอย่างยิ่งจุดบัดกรีที่มองไม่เห็นเหล่านั้นการตรวจสอบด้วยเอกซเรย์อัตโนมัติ (AXI)สามารถแก้ไขปัญหาได้อย่างมีประสิทธิภาพ และยังสามารถดำเนินการตรวจสอบแบบเรียลไทม์เพื่อให้มั่นใจในคุณภาพและการตอบสนองแบบเรียลไทม์สำหรับการควบคุมกระบวนการ
b. มาตรฐานรอยบัดกรี BGA ที่เหมาะสมที่สุด
ข้อต่อบัดกรี BGA ที่เหมาะสมที่สุดควรมีพื้นผิวเรียบ ขอบเขตชัดเจน ปราศจากช่องว่าง และมีเส้นผ่านศูนย์กลาง ปริมาตร ระดับสีเทา และความเปรียบต่างที่คงที่เหมือนกันในข้อต่อบัดกรีทุกจุด โดยต้องมีการจัดแนวที่สมบูรณ์และไม่เกิดลูกบอลบัดกรี เมื่อเปรียบเทียบกับมาตรฐานของข้อต่อบัดกรี BGA ที่เหมาะสม ข้อต่อบัดกรี BGA ที่ผ่านเกณฑ์จะมีข้อกำหนดที่ต่ำกว่า
• การไม่สอดคล้องกัน. อุปกรณ์ตรวจสอบด้วยเอ็กซเรย์สามารถแสดงได้อย่างชัดเจนว่าลูกบอลบัดกรี BGA เข้ากันได้อย่างถูกต้องกับตำแหน่งแผ่นรองบนแผ่น PCB หรือไม่ โดยสามารถยอมให้มีการเยื้องตำแหน่งได้ไม่เกิน 25%
• ข้อต่อบัดกรีหลวมห้ามมีจุดบัดกรีหลวมสำหรับการบัดกรีแบบ BGA
• วงจรเปิดและจุดบัดกรีเย็นเมื่อบัดกรีไม่สัมผัสกับแผ่นรองที่สอดคล้องกันหรือการไหลของตะกั่วบัดกรีไม่ดี อาจทำให้เกิดวงจรเปิดและจุดบัดกรีเย็นได้ วงจรเปิดและจุดบัดกรีเย็นไม่เป็นที่ยอมรับสำหรับการบัดกรี BGA
• การเชื่อมต่อและการลัดวงจรเมื่อมีการใช้บัดกรีมากเกินไปหรือวางไม่เหมาะสม อาจทำให้เกิดการเชื่อมติดกันและวงจรลัดได้ สำหรับจุดบัดกรีแบบ BGA ไม่อนุญาตให้มีการเชื่อมติดกันและวงจรลัด
• ฟันผุ. ประเด็นที่เกี่ยวกับโพรงอากาศค่อนข้างซับซ้อน อุปกรณ์ตรวจสอบด้วยเอกซเรย์สามารถแสดงให้เห็นโพรงอากาศบนการประกอบชิ้นส่วน BGA ได้ เคล็ดลับต่อไปนี้สามารถใช้เป็นมาตรฐานในการตัดสินได้:
1). สาเหตุของการเกิดฟันผุ
① มีโพรงอากาศเกิดขึ้นก่อนการบัดกรีลูกบอลบัดกรี BGA ซึ่งอาจมีสาเหตุมาจากกระบวนการผลิตลูกบอลบัดกรีหรือส่วนประกอบของครีมประสาน
② หากมีการออกแบบรูทะลุให้อยู่ใต้แผ่นแพด อากาศภายนอกจะเข้าสู่ลูกประสานบัดกรีที่หลอมละลายผ่านรูทะลุ ทำให้เกิดโพรงภายในหลังจากการเย็นตัว
③ แผ่นรองมีการเคลือบที่ไม่ดีหรือมีสิ่งปนเปื้อนบนพื้นผิว
④ ตั้งค่าเส้นโค้งอุณหภูมิการบัดกรีแบบรีโฟลว์ไม่เหมาะสม
2). มาตรฐานที่เหมาะสมที่สุดสำหรับฟันผุ
อากาศภายในโพรงอาจก่อให้เกิดผลกระทบด้านความเค้นจากการหดตัวและการขยายตัว ตำแหน่งที่เกิดโพรงจะกลายเป็นจุดรวมความเค้น ซึ่งอาจเป็นสาเหตุสำคัญของการเกิดรอยร้าวจากความเค้น ข้อต่อบัดกรี BGA ที่มีโพรงอาจนำไปสู่ปัญหาทางเทคนิค เช่น การล้มเหลวได้ ตามมาตรฐานของ IPC ที่กำหนดเกี่ยวกับข้อต่อบัดกรี BGA โพรงบนแผ่นแพดต้องมีขนาดไม่เกิน 10% ของพื้นที่ลูกบอลบัดกรี กล่าวคือ เส้นผ่านศูนย์กลางของโพรงต้องไม่เกิน 30% ของเส้นผ่านศูนย์กลางลูกบอลบัดกรี
รับบริการประกอบ BGA SMT ที่มีคุณภาพจาก PCBCart
ในฐานะหนึ่งในผู้ประกอบแผงวงจรพิมพ์ (PCB) ชั้นนำของโลกPCBCart ให้บริการประกอบ SMT อัตโนมัติแบบครบวงจรตามมาตรฐาน IPCด้วยประสบการณ์ด้านการประกอบ SMT กว่า 20 ปี ทำให้เราสามารถจัดการกับชิ้นส่วน BGA ที่มีระยะห่างระหว่างขาเล็กสุดถึง 0.4 มม. ได้แล้ว หากต้องการข้อมูลเพิ่มเติมเกี่ยวกับความสามารถในการประกอบ BGA ของเรา โปรดติดต่อเราหรือคุณสามารถคลิกปุ่มด้านล่างเพื่อส่งคำขอใบเสนอราคาสำหรับความต้องการประกอบ BGA SMT ของคุณได้ ฟรีทั้งหมด!
ขอใบเสนอราคาฟรีสำหรับการประกอบ BGA SMT
แหล่งข้อมูลที่เป็นประโยชน์
•สี่ขั้นตอนในการรู้จัก BGA
•บทนำเกี่ยวกับเทคโนโลยีการบรรจุภัณฑ์แบบ BGA
•ปัจจัยที่มีผลต่อคุณภาพของการประกอบ BGA
•ข้อกำหนดเกี่ยวกับไฟล์การออกแบบเพื่อให้มั่นใจในการประกอบ BGA อย่างมีประสิทธิภาพ
•วิธีขอใบเสนอราคาที่แม่นยำสำหรับความต้องการประกอบ BGA ของคุณ














