การประกอบ BGA (Ball Grid Array Assembly) มีบทบาทสำคัญอย่างยิ่งในการผลิตอุปกรณ์อิเล็กทรอนิกส์สมัยใหม่ ใช้สำหรับติดตั้งชิ้นส่วนอิเล็กทรอนิกส์ขั้นสูงลงบนแผงวงจรพิมพ์ ด้วยการมาถึงของอุปกรณ์อิเล็กทรอนิกส์ที่มีขนาดเล็กลง เร็วขึ้น และล้ำหน้ามากขึ้น การประกอบ BGA จึงได้รับการยอมรับให้เป็นหนึ่งในรูปแบบบรรจุภัณฑ์ที่ได้รับความนิยมมากที่สุดในการออกแบบวงจรอิเล็กทรอนิกส์ประสิทธิภาพสูง
แตกต่างจากชิ้นส่วนอิเล็กทรอนิกส์อื่น ๆ ที่มีขา BGA ประกอบด้วยเมทริกซ์ของลูกบอลประสานที่ด้านล่างของชิ้นส่วนเพื่อให้การเชื่อมต่อกับแผงวงจรพิมพ์
การประกอบแผงวงจรแบบ BGA คืออะไร?
การประกอบ BGA คือกระบวนการเทคโนโลยีการติดตั้งแบบผิวหน้า (SMT) สำหรับติดตั้งแพ็กเกจแบบ Ball Grid Array ลงบนแผงวงจรพิมพ์ (PCB) ผ่านการบัดกรีที่ควบคุมได้ ในการบัดกรีแบบรีโฟลว์ ลูกประสานที่หลอมละลายจะสร้างการยึดเกาะที่แข็งแรงระหว่างวงจรรวมกับแผ่นรองบน PCB มีแพ็กเกจ BGA หลายประเภทเพื่อให้เหมาะสมกับข้อกำหนดด้านไฟฟ้า ด้านการระบายความร้อน และด้านเศรษฐกิจที่แตกต่างกัน:
แพ็กเกจพลาสติกบอลกริดอาร์เรย์ (PBGA)
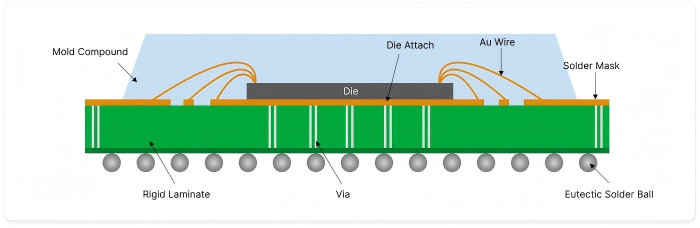
แพ็กเกจพลาสติกบอลกริดอาร์เรย์ (PBGA)
BGA แบบเชื่อมต่อด้วยลวด
ฟลิปชิป BGA (FC-BGA)
BGA ระดับสูงและระยะพิชช์ละเอียด
เนื่องจากจุดบัดกรีไม่สามารถมองเห็นได้และถูกปิดทับด้วยแพ็กเกจของชิ้นส่วน การประกอบแบบ BGA จึงต้องอาศัยการควบคุมกระบวนการและระบบการตรวจสอบที่ซับซ้อนกว่าการประกอบ SMT แบบทั่วไป
กระบวนการประกอบ BGA
กระบวนการประกอบ BGA ใช้เทคโนโลยีขั้นสูงกระบวนการประกอบ SMT:
กระบวนการไหลสำหรับการประกอบ BGA
กระบวนการประกอบเกี่ยวข้องกับขั้นตอนการประกอบ SMT ที่ล้ำสมัยอย่างมาก ขั้นตอนมีดังนี้:
การพิมพ์ครีมประสาน
พิมพ์ครีมประสานลงบนแผ่นรองบัดกรีของแผงวงจรพิมพ์โดยใช้เครื่องพิมพ์สเตนซิล
การวางตำแหน่งชิ้นส่วน BGA
ชิ้นส่วน BGA จะถูกวางลงบนครีมประสานโดยใช้เครื่องจัดวางชิ้นส่วนอัตโนมัติที่มีความทันสมัยสูง เนื่องจากจุดบัดกรีถูกซ่อนไว้
การบัดกรีแบบรีโฟลว์
จากนั้นแผงวงจรพิมพ์ (PCB) จะถูกส่งผ่านเตาอบรีโฟลว์ ในกระบวนการนี้ ลูกบอลประสานจะหลอมละลายและจัดเรียงตัวเองให้ตรงแนวกันเนื่องจากแรงตึงผิว
การตรวจสอบและการยืนยัน
เนื่องจากจุดบัดกรีถูกซ่อนอยู่ จึงทำการตรวจสอบด้วยเอกซเรย์เพื่อยืนยันคุณภาพของจุดบัดกรี
การทำความสะอาดและการทดสอบการทำงาน
การทำความสะอาดทำขึ้นเพื่อยืนยันความเชื่อถือได้ของข้อต่อบัดกรี

ประโยชน์ของการประกอบ BGA
ความหนาแน่นของการเชื่อมต่อสูง
แพ็กเกจแบบ BGA ให้การเชื่อมต่อครอบคลุมทั่วทั้งด้านล่างของอุปกรณ์ จึงสามารถรองรับการเชื่อมต่อ I/O ได้มากขึ้นและช่วยให้การออกแบบแผงวงจรพิมพ์ (PCB) ประหยัดพื้นที่มากขึ้น
ประสิทธิภาพทางไฟฟ้าที่ปรับปรุงดีขึ้น
ความยาวเส้นทางสัญญาณที่สั้นลงช่วยลดค่าความเหนี่ยวนำและความต้านทาน寄生 ทำให้สามารถส่งสัญญาณได้เร็วขึ้นและทำงานที่ความถี่สูงขึ้น
สมรรถนะทางความร้อนที่เหนือกว่า
การจัดเรียงลูกบอลบัดกรีช่วยเพิ่มการกระจายความร้อน ทำให้มั่นใจได้ถึงความเสถียรในการทำงาน
ความน่าเชื่อถือที่เพิ่มขึ้น
การจัดวางตัวเองให้ตรงกันระหว่างกระบวนการรีโฟลว์ ระยะห่างของจุดเชื่อมต่อที่กว้างขึ้น และการบัดกรีแบบอยู่ในระนาบเดียวกัน ช่วยเพิ่มผลผลิตและความน่าเชื่อถือ
ประสิทธิภาพด้านพื้นที่และขนาด
เทคโนโลยี BGA สามารถมอบอุปกรณ์อิเล็กทรอนิกส์ประสิทธิภาพสูงในแพ็กเกจขนาดกะทัดรัด
ประเด็นสำคัญและการควบคุมในการประกอบ BGA ที่ PCBCart
สำหรับกระบวนการประกอบ BGA ให้ประสบความสำเร็จ จำเป็นต้องมีการควบคุมอย่างเข้มงวดทั้งในขั้นตอนการออกแบบและกระบวนการวัตถุดิบ ตลอดจนในกระบวนการประกอบ SMT
การออกแบบและการควบคุมวัตถุดิบ
การเพิ่มประสิทธิภาพการออกแบบ PCB
การวิเคราะห์การออกแบบเพื่อการผลิต (DFM)เป็นปัจจัยสำคัญในการประกอบ BGA ให้ประสบความสำเร็จ วิศวกรต้องวิเคราะห์การออกแบบแพด เลย์เอาต์ และวัสดุอย่างรอบคอบเพื่อหลีกเลี่ยงข้อผิดพลาดในการประกอบ การใช้แผ่นรองแบบ Non-Solder Mask Defined (NSMD) เป็นตัวเลือกที่เหมาะสมช่วยเพิ่มคุณสมบัติการเปียกของบัดกรีและความแข็งแรงของจุดเชื่อม ขนาดแพดที่ถูกต้อง ซึ่งอยู่ในช่วง 0.8 ถึง 1.2 มม. ขึ้นอยู่กับข้อกำหนดของแพ็กเกจ เป็นสิ่งจำเป็นสำหรับการสร้างบัดกรีที่แข็งแรงมั่นคง
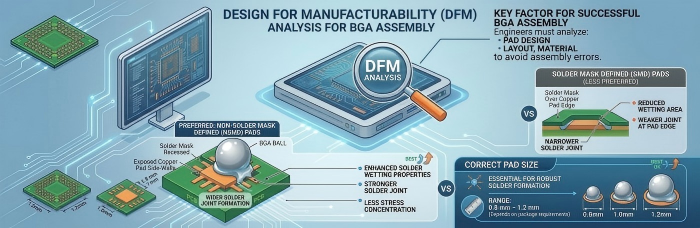
ปัจจัยด้านการออกแบบอื่น ๆ ได้แก่ การจัดการอัตราส่วนทองแดงคงเหลือเพื่อให้เกิดสมดุลความร้อน การปรับตำแหน่งชิ้นส่วนให้เหมาะสมเพื่อหลีกเลี่ยงความขัดแย้ง การใช้วัสดุแผ่น PCB แบบ Tg สูงเพื่อประสิทธิภาพด้านความร้อน และการใช้ผิวเคลือบผิวหน้าที่เข้ากันได้ การตรวจสอบด้านการออกแบบประกอบด้วยการตรวจสอบตามข้อกำหนดของ IPC การทบทวนไฟล์ Gerber การตรวจสอบขั้ว และการตรวจสอบเลย์เอาต์เพื่อลดความเสี่ยงในการผลิต
การควบคุมวัตถุดิบและชิ้นส่วน
วัตถุดิบที่เข้ามาต้องปฏิบัติตามข้อกำหนดที่เข้มงวดมากในการจัดการและการจัดเก็บ ส่วนประกอบต้องผ่านกระบวนการอบและบรรจุสูญญากาศหากมีความไวต่อความชื้น ความชื้นที่ถูกดูดซับโดยส่วนประกอบต้องถูกขับออกก่อนที่จะเข้าสู่กระบวนการรีโฟลว์ ส่วนประกอบต้องได้รับการป้องกันจากการคายประจุไฟฟ้าสถิต ระบบการติดตามด้วยบาร์โค้ดช่วยในการติดตามส่วนประกอบ การตรวจสอบ BOM และข้อกำหนดของส่วนประกอบเป็นสิ่งสำคัญอย่างยิ่ง
การควบคุมกระบวนการผลิตในการผลิต BGA
การควบคุมการพิมพ์ด้วยสเตนซิล
การออกแบบและการพิมพ์สเตนซิลมีผลกระทบอย่างมากต่อจุดบัดกรี ความหนาของสเตนซิลและรูปทรงเรขาคณิตของช่องเปิดจำเป็นต้องได้รับการปรับให้เหมาะสม อัตราส่วนระหว่างความกว้างต่อความหนาก็ต้องได้รับการปรับให้เหมาะสมเช่นกัน ต้องมีการเก็บรักษาบัดกรีแบบครีมให้ถูกต้อง ความเสถียรของบัดกรีแบบครีมมีความสำคัญอย่างยิ่ง ระบบตรวจสอบ 3D SPI ช่วยติดตามคุณภาพของการพิมพ์ การตรวจสอบชิ้นงานแรกช่วยยืนยันความถูกต้องก่อนการผลิตจำนวนมาก
การควบคุมการวางตำแหน่งคอมโพเนนต์
ระหว่างการปฏิบัติงานวางชิ้นส่วน SMT จะใช้เครื่องติดตั้งที่มีความแม่นยำสูงเพื่อให้มั่นใจในความตรงแนวของชิ้นส่วน การตั้งค่าเครื่องป้อน การเลือกหัวดูด และขั้นตอนการตรวจสอบวัสดุจะดำเนินการในลักษณะที่ป้องกันความผิดพลาดในการวางชิ้นส่วน ระบบบริหารการผลิต (Manufacturing Execution System) ช่วยรักษาความสม่ำเสมอในการปฏิบัติงาน ขณะเดียวกันก็มีการใช้มาตรการป้องกันไฟฟ้าสถิต (ESD) เพื่อปกป้องชิ้นส่วนที่ไวต่อความเสียหาย การจัดแนวของชิ้นส่วนยังสามารถตรวจสอบได้โดยใช้เทคโนโลยีเอ็กซเรย์หากจำเป็น
การควบคุมการบัดกรีแบบรีโฟลว์
การปฏิบัติการบัดกรีแบบรีโฟลว์ถือเป็นขั้นตอนที่สำคัญที่สุดในกระบวนการประกอบ BGA เพื่อให้มั่นใจว่าอุณหภูมิเหมาะสมกับแผ่น PCB จะมีการใช้บอร์ดสำหรับการวัดอุณหภูมิในขั้นตอนนี้ นอกจากนี้ยังควบคุมอุณหภูมิอย่างเป็นระบบด้วยเตาอบรีโฟลว์แบบหลายโซนที่ควบคุมความเข้มข้นของออกซิเจนได้ ระดับอุณหภูมิสูงสุดต้องเหมาะสมเพื่อไม่ให้ชิ้นส่วนเสียหายจากความร้อนที่มากเกินไป ช่วงเวลาระหว่างขั้นตอนการพิมพ์และขั้นตอนรีโฟลว์ก็ต้องควบคุมอย่างรอบคอบเช่นกันเพื่อไม่ให้ครีมประสานเสื่อมสภาพ

การทำความสะอาดและการควบคุมกระบวนการหลังการผลิต
การทำความสะอาดจะดำเนินการหลังจากกระบวนการบัดกรีเพื่อกำจัดคราบฟลักซ์ที่อาจส่งผลกระทบต่อความเชื่อถือได้ทางไฟฟ้าในระยะยาว คราบฟลักซ์สามารถกำจัดได้โดยการควบคุมความเข้มข้นของตัวทำละลายและระยะเวลาในการทำความสะอาดอย่างรอบคอบ มีการทดสอบการปนเปื้อนของไอออนบนพื้นผิวเพื่อยืนยันระดับความสะอาด การอบชิ้นงานจะดำเนินการหลังการทำความสะอาดเพื่อกำจัดความชื้นทั้งหมด
การตรวจสอบและการประกันคุณภาพ
เนื่องจากข้อต่อ BGA ไม่สามารถมองเห็นได้ใต้ตัวถังของชิ้นส่วน จึงจำเป็นต้องใช้อุปกรณ์ตรวจสอบที่มีความซับซ้อนสำหรับการประกันคุณภาพ กลยุทธ์การตรวจสอบครอบคลุมทุกแง่มุมของการตรวจสอบ AOIการวิเคราะห์ข้อต่อบัดกรีด้วยการตรวจสอบด้วยเอ็กซเรย์ และการตรวจสอบคุณภาพ การตรวจสอบย้อนกลับจะดำเนินการตลอดกระบวนการผลิต
การบรรจุภัณฑ์และการปกป้องขั้นสุดท้าย
บรรจุภัณฑ์ขั้นสุดท้ายช่วยปกป้องผลิตภัณฑ์ที่ประกอบเสร็จแล้วจากความเสียหายทางกลและการสัมผัสกับสภาพแวดล้อมระหว่างการขนส่งและการจัดเก็บ การใช้วัสดุบรรจุภัณฑ์ป้องกันไฟฟ้าสถิตร่วมกับสารดูดความชื้นช่วยป้องกันความเสียหายที่เกิดจากความชื้นและไฟฟ้าสถิต การแยกแผงวงจรภายใต้การควบคุมความเค้นช่วยลดความเค้นบนจุดบัดกรี ในขณะที่การติดตามด้วยบาร์โค้ดช่วยในการติดตามผลิตภัณฑ์ตลอดกระบวนการโลจิสติกส์
ความสามารถและบริการการประกอบ BGA ของ PCBCart
เพื่อรองรับความต้องการการผลิตอิเล็กทรอนิกส์ที่ซับซ้อน PCBCart จึงให้บริการประกอบ BGA แบบครบวงจร ซึ่งครอบคลุมแพ็กเกจ BGA หลากหลายประเภท เทคนิคการประกอบที่มีความแม่นยำ และกระบวนการประกันคุณภาพที่เหมาะสำหรับการใช้งานในภารกิจสำคัญ
ประเภทแพ็กเกจ BGA ที่รองรับ
เราจัดหาแพ็กเกจ BGA หลากหลายประเภท เช่น PBGA, TBGA, CBGA, FCBGA, EBGA, Micro BGA, PoP, CSP และแพ็กเกจ WLCSP ช่วงแพ็กเกจ BGA ที่รองรับอย่างครอบคลุมช่วยให้สามารถให้บริการผลิตอิเล็กทรอนิกส์ที่หลากหลายสำหรับกลุ่มลูกค้า เช่น อุปกรณ์อิเล็กทรอนิกส์สำหรับผู้บริโภค ระบบอัตโนมัติในอุตสาหกรรม โครงสร้างพื้นฐานด้านการสื่อสาร การประมวลผลประสิทธิภาพสูง และอื่น ๆ อีกมากมาย
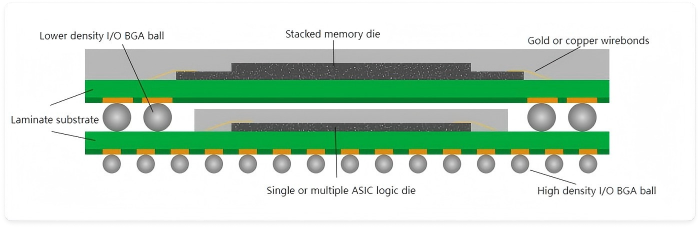
ความสามารถในการประกอบ BGA และ CSP
บริการประกอบ BGA ของเรารวมถึงเทคนิคการประกอบ BGA และ CSP ที่มีความแม่นยำสูงในด้านความสามารถในการผลิต ช่วงขนาด BGA ที่รองรับตั้งแต่ 5 มม. x 5 มม. ถึง 45 มม. x 45 มม. โดยมีระยะพิทช์ของลูกบอลบัดกรีขั้นต่ำได้ถึง 0.3 มม. และเส้นผ่านศูนย์กลางของลูกบอลบัดกรีขั้นต่ำได้ถึง 0.15 มม. ช่วงแพ็กเกจ BGA ที่รองรับประกอบด้วย BGA, LGA, HDA, PoP, uBGA, WLCSP, CSP เป็นต้น
การประกันคุณภาพและการตรวจสอบ
เพื่อให้มั่นใจในคุณภาพของผลิตภัณฑ์ PCBCart ใช้วิธีการตรวจสอบและการยืนยันที่หลากหลาย รวมถึงการตรวจสอบด้วยเครื่องออปติคัลอัตโนมัติ การตรวจสอบด้วยเอกซเรย์สำหรับข้อต่อบัดกรีที่ซ่อนอยู่ และการทดสอบสมรรถนะการทำงาน วิธีการตรวจสอบเหล่านี้สามารถช่วยให้ได้อัตราผลิตภัณฑ์ที่ผ่านมาตรฐานได้อย่างมีประสิทธิภาพ พร้อมทั้งคงไว้ซึ่งสมรรถนะทางไฟฟ้าและทางกล
บริการซ่อมและแก้ไขงาน BGA
นอกจากแบบดั้งเดิมบริการประกอบแผงวงจรพิมพ์ (PCB)นอกจากนี้ PCBCart ยังให้บริการซ่อมแซม BGA แบบมืออาชีพ รวมถึงการรีบอลลิ่ง PCB การปรับแต่งตำแหน่ง BGA การซ่อมหรือทดแทนแผ่นแพดที่เสียหายหรือหายไป การถอดและเปลี่ยนชิ้นส่วนอุปกรณ์ เป็นต้น บริการเหล่านี้สามารถตอบสนองความต้องการด้านการตรวจสอบทางวิศวกรรม การปรับแต่งต้นแบบ และการบำรุงรักษาผลิตภัณฑ์อิเล็กทรอนิกส์ที่ซับซ้อนได้อย่างมีประสิทธิภาพ
ในฐานะองค์ประกอบที่ขาดไม่ได้ในบริการประกอบแผงวงจรพิมพ์ (PCB) เทคโนโลยี BGA มีบทบาทที่ไม่อาจทดแทนได้ในการพัฒนาเทคโนโลยี PCB สมัยใหม่ เมื่อผลิตภัณฑ์อิเล็กทรอนิกส์ยังคงพัฒนาไปในทิศทางของการบูรณาการและการย่อขนาด เทคโนโลยี BGA ยังคงเป็นองค์ประกอบพื้นฐานในการพัฒนาผลิตภัณฑ์อิเล็กทรอนิกส์ขั้นสูง
ด้วยการควบคุมการออกแบบแผ่นวงจรพิมพ์ (PCB) อย่างเข้มงวด เทคนิคการผลิต SMT ที่แม่นยำ เทคโนโลยีการตรวจสอบขั้นสูง และบริการวิศวกรรมแบบครบวงจร ทำให้สามารถบรรลุอัตราผลิตภัณฑ์ที่เชื่อถือได้และความน่าเชื่อถือของผลิตภัณฑ์ในบริการประกอบ PCB ได้ ในฐานะผู้ให้บริการประกอบ BGA มืออาชีพที่มีประสบการณ์มากในด้านบริการประกอบ BGA PCBCart สามารถมอบบริการที่เชื่อถือได้ให้กับคุณในการประกอบแผ่นวงจรพิมพ์แบบ BGA
เริ่มต้นโครงการประกอบ BGA คุณภาพสูงของคุณกับ PCBCart
แหล่งข้อมูลที่เป็นประโยชน์
•รายการตรวจสอบก่อนสั่งซื้อสำหรับโครงการประกอบแผงวงจรพิมพ์ (PCB)
•คู่มือการจัดหาชิ้นส่วน PCB
•ความลับที่น่าประหลาดใจในการออกแบบวิธีการรวมแผง PCB
•แผ่นวงจรพิมพ์รองหลังอะลูมิเนียมสำหรับการใช้งาน BGA กำลังสูง
•ภาพรวมการรับรองคุณภาพของ PCBCart
•บริการประกอบแผงวงจรพิมพ์ต้นแบบ














